Semiconductor
HOME > Products > Equipment > Semiconductor

Marking
Strip marker
(2 beam/4 beam marker)
- 半导体用 4 beam strip 打标机,使用 slot和stack magazine具备loading/unloading的设备。 根据Strip handling的方法分为shuttle类型和rail类型两种,根据顾客要求可采用材料loading/unloading方式可以构成1 in 1 out、2 in 2 out的结构。

| Shuttle type | 把Strip本身放在shuttle上handling |
|---|---|
| Rail type | 可将Strip通过motor,沿着 Rail快速移送 |
Tray marker
(2 beam/4 beam marker)
- 是根据内部配置构分为compact size 'U type'和 conventional 'I type'两种类型的 半导体标记设备。

| U type | 占据空间小,tray移动距离短,操作方便 |
|---|---|
| I type | 可以搭载较大激光器的设备 |
Wafer back side marker
CSM3200/3300
- 使用半导体 chip scale wafer level marker用于wafer背面无损打标的一款设备。
通过自动 calibration自动校正 scanner acuracy,通过自动打标检测功能确认打标结果

| Combination type | 可将FFC 和 wafer在同一个设备加工的复合设备 |
|---|
Wafer top side marker
WTM200/300
- 用于wafer 上进行 Wafer reference die、 bad die、 wafer ID打标的设备 可高速加工,提供操作便利,程序易于更改的wafer top side打标solution
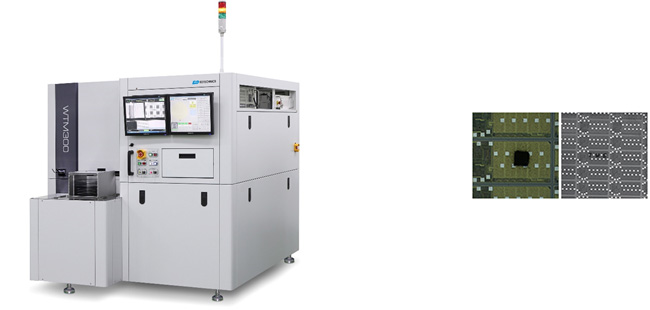
Wafer ID marker
WM080/012
- 用于可在 Cleanroom使用的 wafer ID专用的marking system,可保证高度稳定性并实现高速加工。 搭载了用户可以直接编辑的 OCR edit功能。
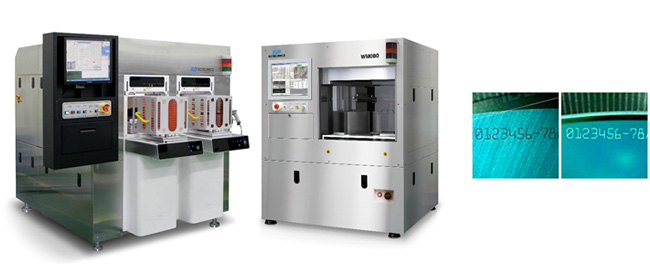
Grooving & Dicing
LMC3200G/LMC3200D
- Grooving - LMC3200G 通过laser scribing,提前去除由wafer
sawlane的Low-k物质及因为金属排线层构成的涂层,
从而在后续Blade Dicing工序处理时,减少芯片的不良发生,提高芯片生产效率。
- Dicing - LMC3200D主要是用激光直接切割厚度在200微米以下的wafer的设备。
与必须经常以消耗性替换刀片的lade Dicing不同,该设备的激光更换零件周期较长,
且结构永久性相对较好,在COO侧面非常有利。
在品质方面,由于是非接触式加工,因此可以减少加工中出现的问题,实现高速加工。

Cutting
PKG cutting
BMC254
- 用于切割各种 Strip (substrate) 的package cutting设备。
采用 Align vision及自动扫描功能,具有高精准性,通过Flying加工方式实现高效生产。
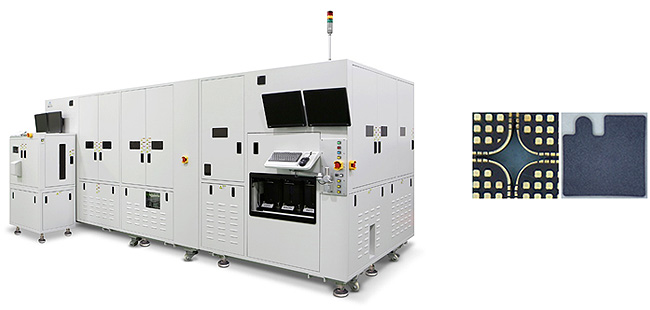
Drilling
PoP drilling
BMC204P
- 适用于 Strip 和 wafer type的 BGA, DSMBGA, POP的package drilling设备。
采用 Align vision及自动扫描功能,具有高精准性,通过Flying加工方式实现高效生产。
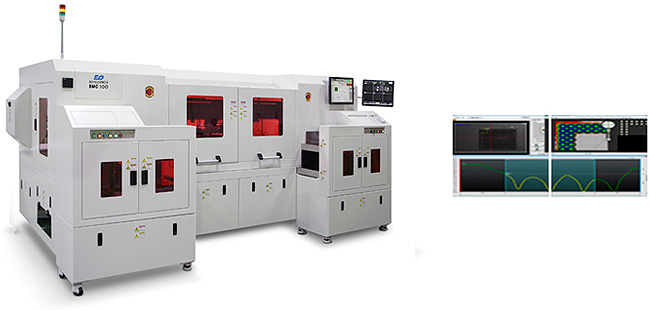

 Chinese
Chinese