Semiconductor
HOME > Products > Equipment > Semiconductor

Marking
Strip marker
(2 beam/4 beam marker)
- 半導体用の4 beam stripマーカーで、slotとstack magazineを使用してloading / unloadingする装置です。
Stripを移送する方法によってshuttleタイプとrailタイプの2種類があり、お客様のニーズに応じて、製品のloading/unloading方式と1 in 1 out、2 in 2 outなどの仕様変更が可能です。

| Shuttle type | Stripをshuttleに乗せた状態で移送させます。 |
|---|---|
| Rail type | tripをindexing motorを使用したrailに沿って移送させます。 |
Tray marker
(2 beam/4 beam marker)
- 内部配置構成に応じて、compact sizeのU typeとconventionalのI typeのmarkerに分類される半導体マーキング装置です。

| U type | Compact tray markerで、狭いスペースに設置可能、tray移動距離が短く、作業が容易。 |
|---|---|
| I type | 比較的に大きいサイズのレーザーを搭載することができる装置。 |
Wafer back side marker
CSM3200/3300
- 半導体chip scale wafer level markerで、ウェハの背面にマーキングする装置です。 自動calibrationを行いマーキング精度を自動補正し、自動マーキング検査機能でマーキング結果を確認することができます。

| Combination type | FFCとwaferを一つの装置で対応する複合マーキング装置。 |
|---|
Wafer top side marker
WTM200/300
- Waferにreference die、bad die、wafer IDをマーキングする装置です。高速加工が可能であり、ユーザの利便性に応じたプログラムの変更が容易なwafer top sideマーキングソリューションを提供しています。
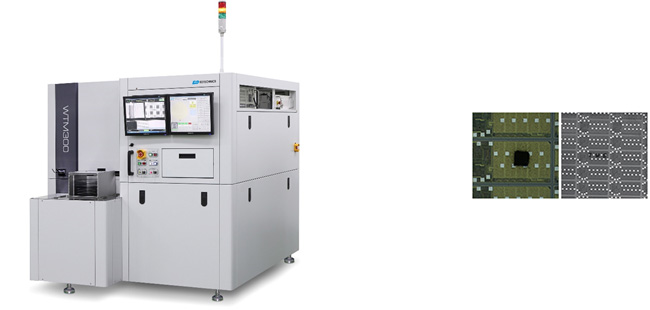
Wafer ID marker
WM080/012
- Cleanroomで使用可能なwafer ID専用marking systemで、高い安定性を確保し、高速加工が可能です。ユーザーが直接編集可能なOCR edit機能を搭載しています。
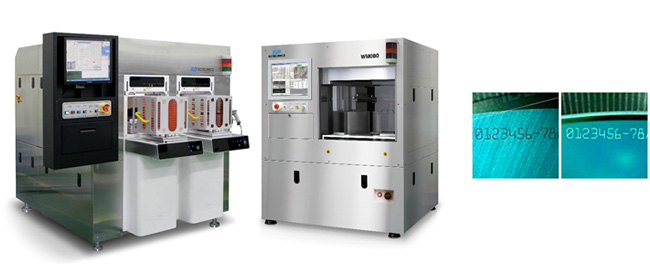
Grooving & Dicing
LMC3200G/LMC3200D
- Grooving
- LMC3200Gは、ウェーハソウレーン(sawlane)のLow-k物質と金属配線層からなるパターン層をレーザースクライビングで、事前に除去することにより、後工程のブレードダイシングを行う時に問題となるチッピング(chipping)を最小化し、チップ生産の歩留まりを向上させます。
- Dicing
- LMC3200Dは、主に厚さ200㎛以下の薄いウェハをレーザーでダイシングする装置です。ブレードの消耗で頻繁に交換しなければなら既存のブレードダイシングとは異なり、レーザーは、部品の交換周期が長く、比較的、半永久的なのでCOOの観点から非常に有利です。品質面では、非接触加工であるため、チッピングの問題を画期的に減らしながらの高速加工が可能になります。

Cutting
PKG cutting
BMC254
- 各種Strip(substrate)を切断するpackage cutting装置です。Align visionと自動スキャナ補正機能を使用するので、高精度でありながら、flying加工方法を入れ、高い生産性を実現します。
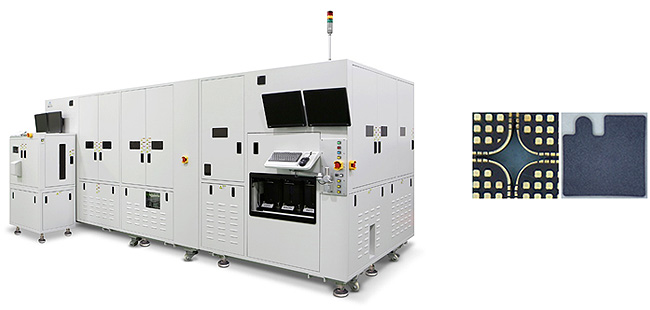
Drilling
PoP drilling
BMC204P
- Stripとwafer typeのBGA、DSMBGA、POPに適用可能なpackage drilling装置です。 Align visionと自動スキャナ補正機能を使用して高精度ながら、flying加工方法を適用して高い生産性を実現します。
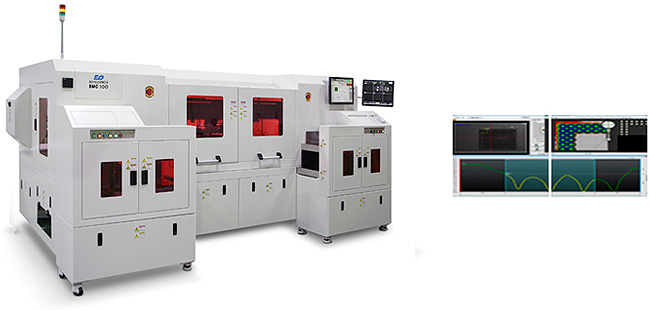
Laser annealing
Wafer annealing
- Siウェハ上で結晶化(Crystallization)、ドーパント活性化(activation)、表面溶融(melting)、ボイド除去を行う装置です
- レーザー波長の選択が可能で、高い生産性とすべてのプロセス条件に対するリアルタイムモニタリングが可能です
- レーザー波長に応じた光学系の選択ができ、目的に応じたビーム形状を実現できます
| LAton | LAton-R | LApollon |
|---|---|---|
| · 基本型 - Melting & Void seam除去 - Crystallization - Dopant activation | · 工程改善型 - 基本形を含む - Energy stabilityの向上 - Jitter stabilityの改善 - Pulse形状ばらつきの改善 | · 生産性改善型 - 工程改善型を含む - LAton-R比で生産性が25%向上 |

| Laser | 広範囲のwavelength対応可能 |
|---|---|
| Optic | 多様なビームタイプに応じた光学系に対応可能 |
Power device annealing
- SiCオーミックコンタクト用のニッケルシリサイド形成およびIGBT裏面ドーパント活性化のための装置です.
- レーザー波長の選択が可能で、高い生産性とすべてのプロセス条件に対するリアルタイムモニタリングが可能です.
- レーザー波長に応じた光学系の選択ができ、目的に応じたビーム形状を実現できます.
- ULA-200A
| · 基本型 - Nickel silicideの生成 - Crystallization - Dopant activation |
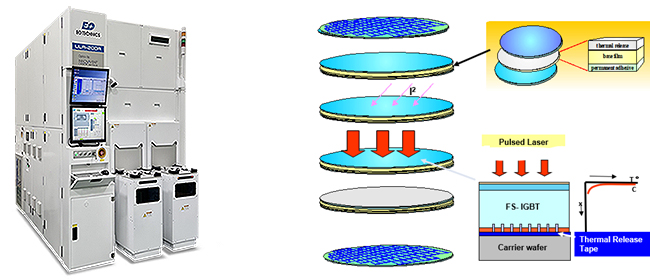
| Laser | 広範囲のwavelength対応可能 |
|---|---|
| Optic | 多様なビームタイプに応じた光学系に対応可能 |
Debonding
WD400U/BMDB400UPN
- WD400U/BMDB400UPNは、ウェハ/パネルレベルに対応可能な装置であり、 薄型または反りの大きい材料に適用されるキャリアを、プロセス中またはプロセス後に材料から剥離することで、 スムーズなウェハ/パネル工程の進行を実現します。


 Japanese
Japanese