Semiconductor
HOME > Products > Equipment > Semiconductor

Marking
Strip marker
(2 beam/4 beam marker)
- 반도체용 4 beam strip 마커로 slot 과 stack magazine을 사용하여 loading/unloading 하는 장비입니다.
Strip 핸들링 방법에 따라 shuttle 타입과 rail 타입의 두 종류가 있으며 고객 요구에 따라 자재 loading/unloading
방식 및 1 in 1 out, 2 in 2 out 등의 구성이 가능합니다.

| Shuttle type | Strip 자체를 shuttle에 올려 핸들링 |
|---|---|
| Rail type | Strip을 indexing motor로 rail 따라 이동, 빠른 이송 가능 |
Tray marker
(2 beam/4 beam marker)
- 내부 배치 구성에 따라 compact size ‘U type’과 conventional ‘I type’ marker로 분류되는 반도체 마킹 장비입니다.

| U type | Compact tray marker로 작은 공간 차지 tray 이동 거리가 짧아 작업 용이 |
|---|---|
| I type | 자재 종류에 따라 Laser type 변경 탑재가 가능 |
Wafer back side marker
CSM3200/3300
- 반도체 chip scale wafer level marker로 웨이퍼 후면에 칩 손상 없이 마킹하는 장비입니다.
Calibration을 통해 scanner accuracy를 자동 보정하고 자동 마킹 검사 기능을 통해 마킹 결과를 확인할 수 있습니다.

| Combination type | FFC와 wafer를 한 장비에 적용 가능한 복합 마킹 장비 |
|---|
Wafer top side marker
WTM200/300
- Wafer에 reference die, bad die, wafer ID를 마킹하는 장비입니다.
고속 가공이 가능하며 사용자의 편의에 따른 프로그램 변경이 용이한 wafer top side 마킹 솔루션을 제공합니다.
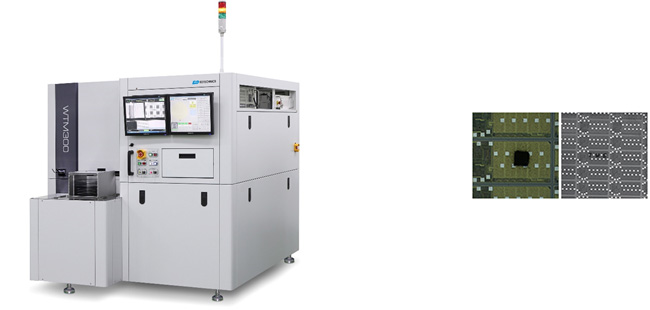
Wafer ID marker
WM080/012
- Cleanroom에서 사용 가능한 wafer ID 전용 marking system으로 고도의 안정성을 보장하며 고속 가공이 가능합니다.
사용자가 직접 편집 가능한 OCR edit 기능을 탑재하고 있습니다.
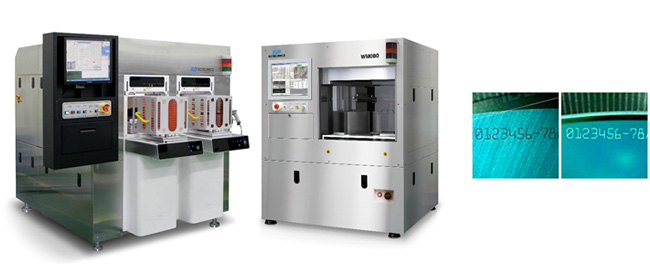
Grooving & Dicing
LMC3200G/LMC3200D
- Grooving - LMC3200G는 웨이퍼 쏘우레인(sawlane)의 Low-k 물질 및 금속 배선층으로 이루어진 패턴층을 레이저
스크라이빙을 통해 미리 제거함으로써, 후속 공정인 블레이드 다이싱 시에 문제가 되는 칩핑(chipping)을
최소화하여 칩생산수율을 향상시키게 합니다.
- Dicing - LMC3200D는 주로 두께 200㎛이하의 얇은 웨이퍼를 레이저로 직접 절단하는 장비입니다.
블레이드 날을 소모성으로 자주 교체해야만 하는 기존 블레이드 다이싱과 달리 레이저는 부품교체 주기가
길고 반영구적이어서 COO 측면에서 상당히 유리합니다. 품질측면에서는 비접촉식 가공이 이루어지기 때문에 칩핑 문제를 획기적으로 줄이면서 고속 가공이 가능하도록 합니다.

Cutting
PKG cutting
BMC254
- 각종 Strip(substrate)을 절단하는 package cutting 장비입니다.
Align vision 및 자동 스캐너 보정 기능을 사용하여 높은 정확성을 가지며, flying 가공 방식을 통해 높은 생산성을 구현합니다.
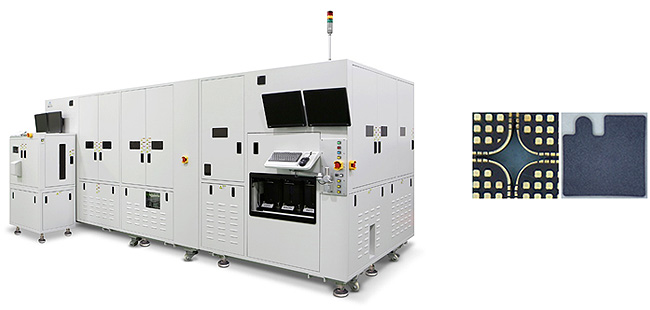
Drilling
PoP drilling
BMC204P
- Strip 및 wafer type의 BGA, DSMBGA, PoP에 적용 가능한 package drilling 장비입니다.
Align vision 및 자동 스캐너 보정 기능을 사용하여 높은 정확성을 가지며, flying 가공 방식을 통해 높은 생산성을 구현합니다.
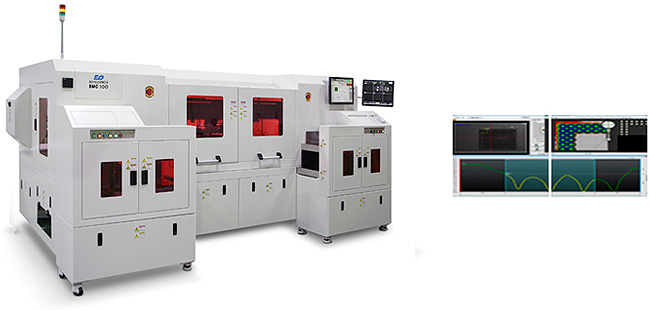
Laser annealing
Wafer annealing
- Si wafer에 Crystallization, Dopant activation, 표면 melting, void 제거를 하는 설비입니다.
- Laser 파장 선택이 가능하고, 높은 생산성, 모든 공정 조건에 대한 실시간 monitoring이 가능합니다.
- Laser 파장에 따른 광학 선택이 가능하고, 원하는 형태의 beam shape이 가능합니다.
| LAton | LAton-R | LApollon |
|---|---|---|
| · 기본형 - Melting & Void seam 제거 - Crystallization - Dopant activation | · 공정 개선형 - 기본형 포함 - Energy stability 향상 - Jitter stability 개선 - Pulse shape 산포 개선 | · 생산성 개선형 - 공정 개선형 포함 - LAton-R 대비 25% 생산성 향상 |

| Laser | 넓은 범위의 wavelength 대응 가능 |
|---|---|
| Optic | 다양한 beam type 에 따라 optic 대응 가능 |
Power device annealing
- SiC ohmic contact을 위한 Nickel silicide 생성 및 IGBT 후면 dopant activation를 위한 설비입니다.
- Laser 파장 선택이 가능하고, 높은 생산성, 모든 공정 조건에 대한 실시간 monitoring이 가능합니다.
- Laser 파장에 따른 광학 선택이 가능하고, 원하는 형태의 beam shape이 가능합니다.
- ULA-200A
| · 기본형 - Nickel silicide 생성 - Crystallization - Dopant activation |
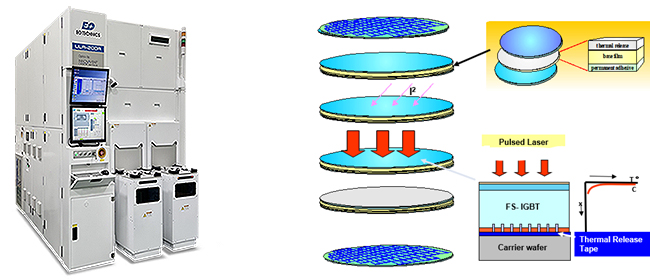
| Laser | 넓은 범위의 wavelength 대응 가능 |
|---|---|
| Optic | 다양한 beam type 에 따라 optic 대응 가능 |
Debonding
WD400U/BMDB400UPN
- WD400U/BMDB400UPN는 웨이퍼/패널레벨대응 가능한 설비로 얇거나 warp이 심한 자재에 적용되는 carrier를 공정중 또는 후에 자재로부터 떼어내어, 원활한 웨이퍼/패널 공정진행을 가능하게 합니다.


 Korean
Korean